2.5D封装与3D IC封装主流产品介绍
2.5D封装是通过TSV转换板连接芯片,而3D IC封装是将多个芯片垂直堆叠在一起,并通过直接键合技术实现芯片间的互连。在 3D 结构中,有源芯片通过芯片堆叠集成,以实现最短的互连和最小的封装尺寸。SoIC 技术将同类和异构小芯片集成到单个类似 SoC 的芯片中,该芯片具有更小的尺寸和更薄的外形,可以单片集成到高级 WLSI(又名 CoWoS 和 InFO)中。2.5D封装和3D IC封装都是新兴
·
1、3D 结构与 2.5D 有何不同?
首先,2.5D封装和3D IC封装的互连方式有所不同。2.5D封装是通过TSV转换板连接芯片,而3D IC封装是将多个芯片垂直堆叠在一起,并通过直接键合技术实现芯片间的互连。在 2.5D 结构中,两个或多个有源半导体芯片并排放置在硅中介层上,以实现极高的芯片到芯片互连密度。在 3D 结构中,有源芯片通过芯片堆叠集成,以实现最短的互连和最小的封装尺寸。


英特尔的EMIB


台积电的CoWoS技术
台积电的CoWoS技术也是一种2.5D封装技术。根据中介层的不同,可分为三类。一是CoWoS_S(使用Si衬底作为中介层),二是CoWoS_R(使用RDL作为中介层),三是CoWoS_L(使用小芯片(Chiplet)和RDL作为中介层)。三星的I-Cube
三星的I-Cube
三星的先进封装包括四种解决方案:I-Cube、X-Cube、R-Cube和H-Cube。其中,三星的I-Cube属于2.5D套餐。3、3D IC封装主流产品介绍台积电SoIC技术
台积电SoIC技术
台积电的SoIC技术属于3D封装,是wafer-on-wafer键合技术。SoIC技术采用TSV技术,可以实现非凸点键合结构,将许多不同性质的相邻芯片集成在一起。SoIC 技术将同类和异构小芯片集成到单个类似 SoC 的芯片中,该芯片具有更小的尺寸和更薄的外形,可以单片集成到高级 WLSI(又名 CoWoS 和 InFO)中。新集成的芯片从外观上看是一颗通用SoC芯片,但内嵌了所需的异构集成功能。英特尔的 Foveros 技术

更多推荐
 已为社区贡献2条内容
已为社区贡献2条内容


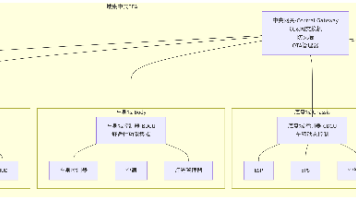





所有评论(0)