bga bond焊盘 wire_封装模式: FC-BGA VS. WireBond ,谁是封装工艺中的真英雄?(图)
( 双敏电子提供)最近这几天,双敏电子发布了第一款基于FC-BGA封装的5600 XTFC-BGA封装WireBond封装通常,幕后英雄都是不吸引人注目的,拿显示芯片来说,我们关心的主要是架构、总线接口、时钟速度,当讲到制造工艺对性能有关的影响时,也不过说说内核面积、成品率、电路尺寸之类,然而,许多人都没有注意到一个影响显示核心稳定性、性能、时钟速度的关键因素----封装。显示芯片也好、CPU也一
( 双敏电子提供)最近这几天,双敏电子发布了第一款基于FC-BGA封装的5600 XT

FC-BGA封装

WireBond封装
通常,幕后英雄都是不吸引人注目的,拿显示芯片来说,我们关心的主要是架构、总线接口、时钟速度,当讲到制造工艺对性能有关的影响时,也不过说说内核面积、成品率、电路尺寸之类,然而,许多人都没有注意到一个影响显示核心稳定性、性能、时钟速度的关键因素----封装。显示芯片也好、CPU也一样,都是主要分为两个部分:硅片部分是处理器的主体,封装是连结内核与外部世界的桥梁。封装格式决定它可以达到的工作频率,并能控制外频,换句话说,它将对

WireBond工艺封装示意图
那么这二者相比,FC-BGA的优势在什么地方呢?首先,它解决了电磁兼容(EMC)与电磁干扰(EMI)问题。一般而言,采用WireBond封装技术的芯片,其信号传递是透过具有一定长度的金属线来进行,这种方法在高频的情况下,会产生所谓的阻抗效应,形成信号行进路线上的一个障碍;但FC-BGA用小球代替原先采用的针脚来连接处理器,这种封装共使用了479个球,但直径均为0.78毫米,能提供最短的对外连接距离。采用这一封装不仅提供优异的电性效能,同时可以减少组件互连间的损耗及电感,降低电磁干扰的问题,并承受较高的频率,突破超频极限就变成了可能。

FC-BGA工艺封装示意图
其次,当显示芯片的设计人员在相同的硅晶区域中嵌入越来越密集的电路时,输入输出端子与针脚的数量就会迅速增加,而FC-BGA的另一项优势是可提高I/O的密度。一般而言,采用WireBond技术的I/O引线都是排列在芯片的四周,但采用FC-BGA封装以后,I/O引线可以以阵列的方式排列在芯片的表面,提供更高密度的I/O布局,产生最佳的使用效率,也因为这项优势,倒装技术相较于传统封装形式面积缩小30%至60%。
最后,在新一代的高速、高整合度的显示芯片中,散热问题将是一大挑战。基于FC-BGA 独特的倒装封装形式,芯片的背面可接触到空气,能直接散热。同时基板亦可透过金属层来提高散热效率,或在芯片背部加装金属散热片,更进一步强化芯片散热的能力,大幅提高芯片在高速运行时的稳定性。

由此,我们可以看到FC-BGA将会给双敏电子的这款小妖G 5618XT双敏电子提供 2003-11-11)
更多推荐
 已为社区贡献1条内容
已为社区贡献1条内容


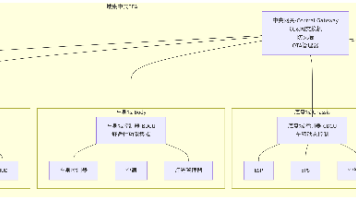





所有评论(0)