文献阅读(178)chiplet成本
文章目录题目:Chiplet Actuary: A Quantitative Cost Model and Multi-Chiplet Architecture Exploration时间:2022会有:DAC研究机构:清华马恺声本篇论文的主要贡献: 针对chiplet成本的量化分析模型以及分析方法chiplet确实可以提高芯粒良率,但同时也会增加其他的成本,包括基板、D2D开销以及NRE成本,本
- 题目:Chiplet Actuary: A Quantitative Cost Model and Multi-Chiplet Architecture Exploration
- 时间:2022
- 会有:DAC
- 研究机构:清华马恺声
- 参考链接:
本篇论文的主要贡献: 针对chiplet成本的量化分析模型以及分析方法
chiplet确实可以提高芯粒良率,但同时也会增加其他的成本,包括基板、D2D开销以及NRE成本,本篇论文便是首次分析了D2D的间接费用以及NRE成本
方法
良率模型: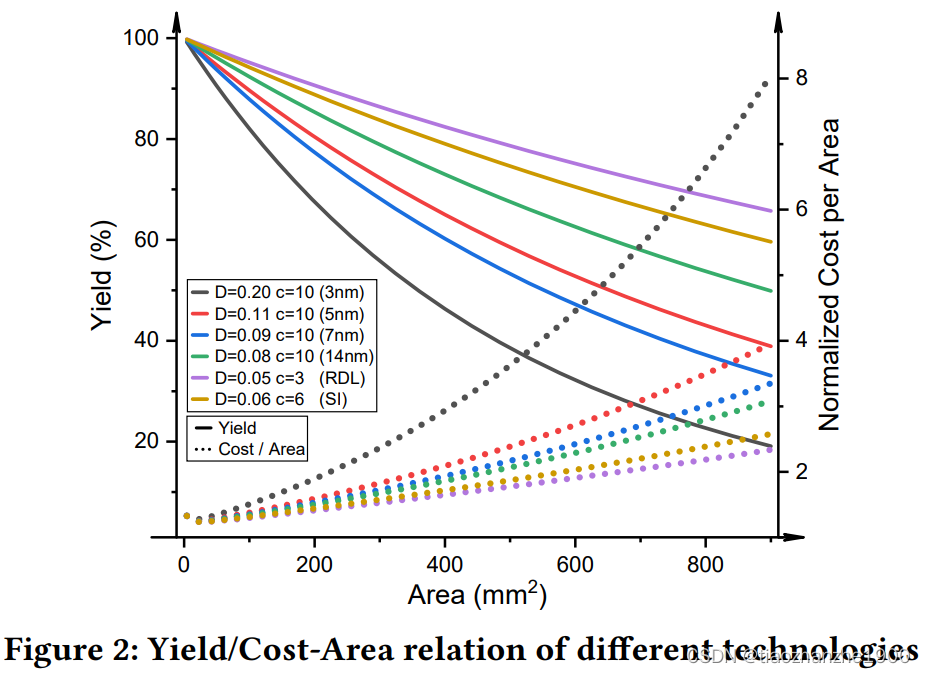
chiplet复用方式可以分为三类:
- 单芯片多系统(SCMS):完全同构的情况,显然NRE成本会减少很多
- 一中心多拓展(OCME)
- 固定插座多组合(FSMC)
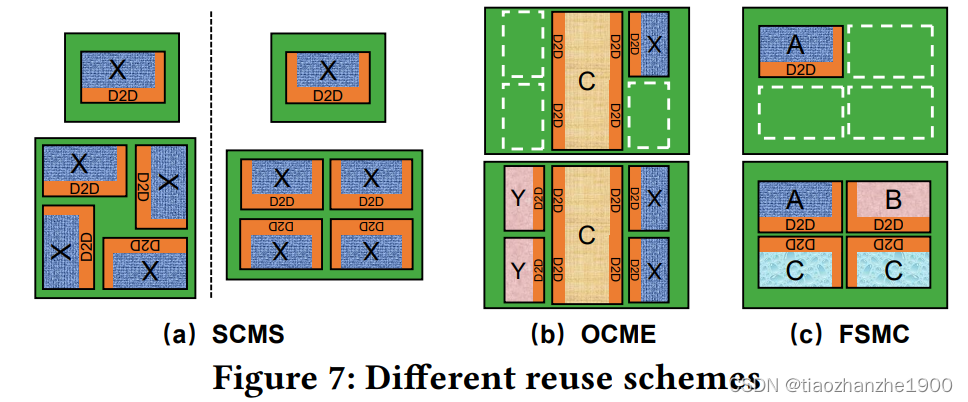
实验
数据来源: commercial databases、public information
如何验证模型准确? 带入AMD的zen3架构的参数,MCM节省的成本最多可达50%,与AMD声称的一致
The comparison shows die costs result similar with AMD. Multi-chip integration can save up to 50% of the die cost.

上图横坐标是不同工艺与不同芯片面积,纵坐标是单位面积的成本。其中成本主要考虑了RE Cost(recurring engineering cost,可以理解成不考虑一次性投入,生产一片芯片的钱),包括
- cost of raw chips
- cost of chip defects
- cost of raw package
- cost of package defects
- cost of wasted KGD(known good dies)
显然,芯片面积越大,chip defects带来的成本就更高;随着chiplet封装工艺的提升,raw package和packaging defects的成本也就越高。
结论:
- 工艺制程不够先进的,没必要做Chiplet
- 芯片面积不够大的,没必要做chiplet
- 5nm800mm2面积的SoC中,chip defects导致的额外成本占总制造成本的50%以上
更多推荐
 已为社区贡献2条内容
已为社区贡献2条内容







所有评论(0)